关键词 |
晶圆挑片器半导体扶梯,重庆晶圆挑片器,销售晶圆挑片器,晶圆挑片器晶圆刻号器 |
面向地区 |
全国 |
晶圆经过前道工席后芯片制备完成,还需要经过切割使晶圆上的芯片分离下来,后进行封装。不同厚度晶圆选择的晶圆切割工艺也不同:
厚度100um以上的晶圆一般使用刀片切割;
厚度不到100um的晶圆一般使用激光切割,激光切割可以减少剥落和裂纹的问题,但是在100um以上时,生产效率将大大降低;
厚度不到30um的晶圆则使用等离子切割,等离子切割速度快,不会对晶圆表面造成损伤,从而提高良率,但是其工艺过程更为复杂。
以稳定的扭矩运转的系统要求进给率、心轴速度和冷却剂流量的稳定。冷却剂在刀片上施加阻力,它造成扭力。新一代的切片系统通过控制冷却剂流量来保持稳定的流速和阻力,从而保持冷却剂扭矩影响稳定。当切片机有稳定的冷却剂流量和所有其它参数都受控制时,维持一个稳定的扭矩。如果记录,从稳定扭矩的任何偏离都是由于不受控的因素。这些包括由于喷嘴堵塞的冷却剂流量变化、喷嘴调整的变化、刀片对刀片的变化、刀片情况和操作员错误。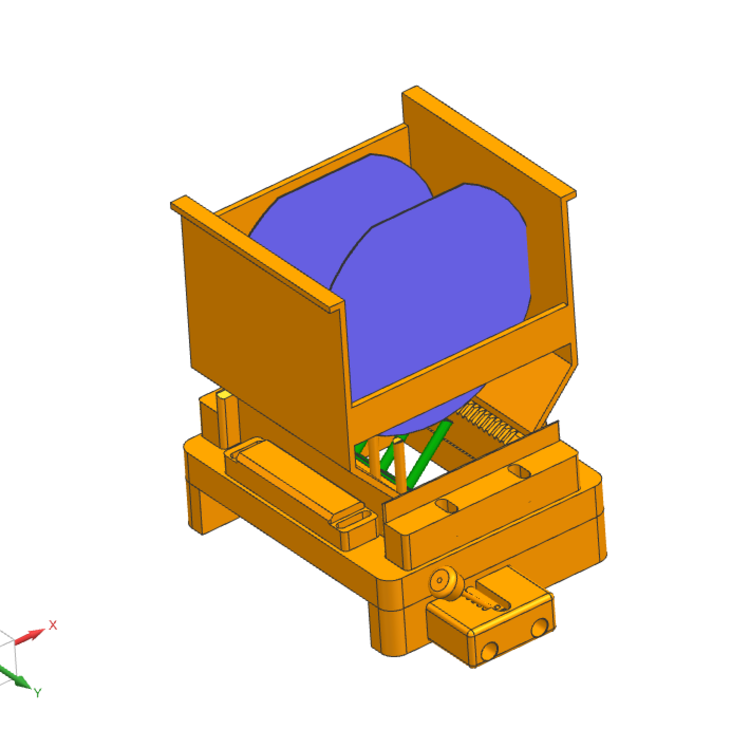
UV膜与蓝膜相比,它的粘性剥离度可变性使得其性很大,主要作用为:用于wafer减薄过程中对wafer进行固定;water划切过程中,用于保护芯片,防止其脱落或崩边,用于wafer的翻转和运输,防止已经划好的芯片发生脱落。规范化使用UV膜和蓝膜的各个参数,根据芯片所需要的加工工艺,选择合适的UV膜或者蓝膜,即可以节省成本,又可以加进芯片产业化发展。
